
[시사저널e=고명훈 기자] “후공정 기술로 AI 시대 학습용 칩과 추론용 칩 분야를 모두 공략할 것입니다. ”
반도체 후공정업체 네패스가 인공지능(AI) 반도체 패키징 시장에 뛰어든다. 시스템반도체 분야에서 후공정 기술을 개발해온 네패스는 AI 반도체 시대에 맞는 후공정 기술로 시장 공략에 나섰다.
15일 강인수 네패스 반도체연구소장(전무)은 “AI 반도체는 대량의 데이터를 훈련하는 학습용 칩과 알고리즘 공식이 들어간 ‘엣지 컴퓨팅(추론용 칩) 시장으로 구분할 수 있으며 양 시장을 모두 공략하려고 한다”고 말했다.
네패스가 개발한 기술은 재배선(RDL) 인터포저와 실리콘 브릿지 분야다. RDL 인터포저는 반도체 회로와 기판 회로를 사이 새 회로를 구성하는 부품이다. 2D 구조의 칩렛과 기판 사이에 해당 부품을 끼워 넣는 방식이어서 2.5D 패키징 기술로 불린다.
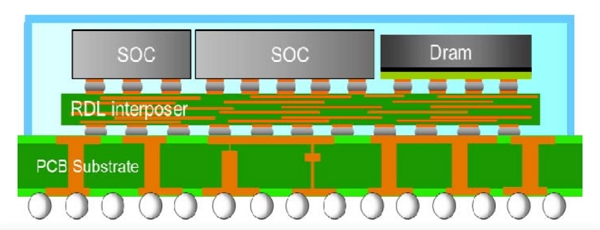
네패스는 지난해 ‘2023년 세계일류상품 및 생산기업’ 선정 수여식에서 웨이퍼 레벨 패키징(WLP) 기술이 ‘현재 세계일류상품’에 선정된 바 있다. 해당 기술에서 글로벌 시장 5위 안에 들거나 점유율 5% 이상을 차지하는 기업으로 인정받은 것이다. 지난해 ‘칩렛 이종 집적 초고성능 AI 반도체 개발’ 국책과제에 선정돼 연구개발을 이어가고 있다.
강 전무는 “국내에서 팬아웃(FO)-WLP 기술을 양산하는 유일한 기업이다 보니 지난해 국책과제에도 선정돼 좋은 기회를 얻게 되지 않았나 생각한다”라고 말했다.
다음은 강 전무와의 일문일답.
-국내 대부분의 반도체 패키징 회사들이 메모리를 중심으로 하고 있는데, 네패스는 시스템반도체로 시작했다. 어떤 계기가 있었나
우리는 메모리가 아니라 디스플레이구동칩(DDI)이란 컨슈머 제품으로 사업을 시작했다. 사업을 시작할 당시 모니터가 화면출력용 브라운관(CRT)에서 박막트랜지스터(TFT) 액정디스플레이(LCD)로 전환되면서 시기와 잘 맞물렸다고 볼 수 있겠다. LCD 패널은 반도체로 구동해줘야 해서 칩들이 들어가야 하는데, 기존 전통적인 방식의 와이어본딩이 아니라 WLP 공법을 써서 하는 것이었다. 또, LCD에서 유기발광다이오드(OLED)로 넘어가면서 모니터 안에 들어가는 DDI가 10개 이상이 되다 보니 시장이 성장세를 타고 있었다. 연구개발(R&D)과 거래선과의 긴밀한 협업을 통해 WLP 기술에 좀 더 집중했다.

-네패스의 WLP 기술력이 글로벌에서 어느 정도 수준인가
처음 스마트폰이 나올때 반도체 부품이 20개 정도에 불과했다면 지금은 100~200개 사이라고 봐야 한다. 한정된 체적(입체가 차지하는 공간 크기)에 반도체 부품을 계속 늘려야 하는 상황인데 그러려면 부품은 더 작아져야 한다. 현존하는 기술 중 칩을 가장 작게 만들 수 있는 패키지가 WLP였던 것이다. 열심히 연구해서 다양한 크기의 디바이스에 WLP를 적용했던 연구 데이터들을 모아서 2009년 국제 WLP 컨퍼런스인 ‘IWLPC’에서 발표했는데 베스트 어워드를 수상하게 됐다. 회사를 많이 알리는 계기가 됐다.
글로벌 회사들과 직접 비교해도 기술력은 우리가 밀리지 않는다고 생각한다. 다만 규모의 차이는 있다. 그쪽은 우리에게 없는 기존의 전통 패키지들을 어마어마한 규모로 갖고 있다. 우리는 WLP에 중점을 두고 있다. 글로벌 기업들이 모든 디바이스를 고르게 다 할 수 있다면, 우리는 스마트폰에 특화된, 또는 자동차에 특화된 고객사들이 찾는 것이다. 이런 고객사 입장에서 종합반도체를 지향하는 패키지 업체에서 하나만 빼 진행하는 것보다는 특정 분야를 더 잘하는 우리 같은 기업이 편할 것이다. 또 예상치 못한 상황에 대비해 플랜B를 갖춰야 하는 점도 있을 것이다.
-네패스는 WLP의 차세대 기술인 FO 기술에도 집중하고 있다
공법이 발전할수록 칩 사이즈는 줄어든다. WLP와 일반 보드를 연결할 때 그 위에 솔더볼을 배치하는데, 이때 솔더볼의 간격에는 일정한 규격이 정해져 있다. 결국 칩 하나에 솔더볼의 개수가 정해져 있는 건데, 이를 극복하기 위해 솔더볼을 칩 영역 외로 넘어가서 배치하는 것이 FO 기술이다. FO에서는 칩의 영역을 인위적으로 키우는 패널리제이션 공정이 추가된다.
FO 패키징 방식은 기존 시스템반도체에서 메모리까지 앞으로 모든 영역에 다 쓰일 것이다. 특히, 메모리에서 어려운 점이 최적화인데, 패키지에서 솔더볼의 위치 규격이 정해져 있다 보니 다른 디바이스들과 합칠 때 제한이 있다. FO를 활용하면 솔더볼을 원하는 위치에 만들 수 있어 커스터마이즈가 가능하단 장점이 있다.
-네패스는 패키징에 이어 자회사 네패스아크의 테스트 사업까지 후공정 전과정을 사업분야로 뒀다. 확실한 장점이 있을 것으로 보이는데
후공정 분야 2.5D는 테스트 기술이 가장 어렵다. 신경계처리장치(NPU) 4개에 고대역폭메모리(HBM) 8개로 구성되다 보니 테스트 난이도가 굉장히 높은 것이다. 예전에 단순 전력반도체(PMIC)의 경우는 하나의 패키지라서 외관 검사만 해도 된다고 봤다. 그러나 점점 첨단 패키지로 가면서 테스트 솔루션 없이는 지금 얘기하는 첨단 패키지 개발도 어렵다고 본다. 테스트 영역과의 콜라보레이션이 굉장히 중요한 것이고, 패키지 회사에 테스트 전문 회사가 같이 있는 건 큰 이점이 된다. 우리도 정부로부터 국제과제에 선정되고 돌아와 가장 먼저 찾아간 곳이 네패스아크 연구소였다.
-하 략-
원문보기 https://www.sisajournal-e.com/news/articleView.html?idxno=402046
