-
 NEWS
NEWS
-
 네패스, AI서버향 전력 반도체 수요로 턴어라운드 기대 - 대신증권
네패스, AI서버향 전력 반도체 수요로 턴어라운드 기대 - 대신증권- 24년 매출액 기준 반도체 71%, 전자재료 17%, 이차전지 11%로 구성.- 반도체 부문은 고부가가치 패키징으로 분류되는 WLP(웨이퍼레벨 패키징)가 대부분 매출을 차지- 국내 유일 FOPLP 패키징 수행이 가능한 업체나 양산 매출이 발생하지 않음에 따라 24년 중단사업으로 분류, 재무구조 안정화 도모- 주력 사업인 WLP 전방 시장이 스마트폰에서 AI서버 향으로 비중 확대 중.. 25년 4월, AI반도체용 패키징 라인 증설 결정- 25년 전자재료 HBM향 구리 도금액 매출의 지속 성장, 이차전지 역시 리드탭 실적 회복하며 턴어라운드 기대자료출처: 네패스 종목분석 - AI서버향 전력 반도체 수요로 턴어라운드 기대 : 네이버페이 증권
2025-08-27 -
![[보도]소부장 핵심기업 '네패스' 국내 복귀…공급망 퍼즐 맞춘다 -산업부 정책뉴스 썸네일](https://www.nepes.co.kr/data/bbsData/17560881619.jpg) [보도]소부장 핵심기업 '네패스' 국내 복귀…공급망 퍼즐 맞춘다 -산업부 정책뉴스
[보도]소부장 핵심기업 '네패스' 국내 복귀…공급망 퍼즐 맞춘다 -산업부 정책뉴스산업통상자원부는 12일 박정성 무역투자실장이 국내 복귀 기업 선정서 수여를 위해 반도체 패키지 제조기업인 ㈜네패스 청주공장을 찾았다고 밝혔다.박 실장은 네패스의 투자계획 설명을 들은 뒤 생산 현장과 투자 예정부지를 살펴보고 유턴과정에서의 애로사항 등을 청취하는 한편, 국내 복귀 기업에 대한 정부 지원방안 등에 대해 논의했다.네패스는 시스템 반도체 후공정의 모든 과정을 일괄공급하는 종합 후공정 파운드리 전문기업으로, 소부장 핵심전략기술 보유 기업이다.네패스는 국내외 반도체기업 대상 제품 생산 확대를 위해 충북 청주공장 유휴부지에 생산시설을 증설할 계획이다.정부는 글로벌 공급망 재편이 가속하는 상황에서 한국을 글로벌 공급망 거점 기지화하고 국내 투자를 활성화하기 위해 첨단·공급망 핵심 기업의 유턴을 적극 추진하고 있다.이에 네패스의 청주공장 투자는 신규고용을 통한 지역경제 활성화와 수출 확대, 공급망 안정 등 국가경제에 기여할 것으로 기대된다.박정성 무역투자실장은 "소부장 핵심기업의 국내 복귀는 투자·고용·수출 등 경제적 효과가 크고 국내 공급망 안정화에 매우 중요하다"고 강조하면서 "특히 글로벌 기술경쟁이 심화하는 상황에서 네패스 같은 우수기업의 국내 복귀는 매우 고무적"이라고 밝혔다.이어서 "정부는 앞으로 제도개선 등으로 기업의 국내 복귀를 전폭 지원할 계획"이라고 덧붙였다.문의: 산업통상자원부 투자정책관 해외투자과(044-203-4069)[출처] 대한민국 정책브리핑(www.korea.kr)
2025-06-13 -
 네패스 김종헌 부사장 “첨단 패키징, 국가 주도 오픈 플랫폼으로 도약해야”
네패스 김종헌 부사장 “첨단 패키징, 국가 주도 오픈 플랫폼으로 도약해야”반도체 첨단패키징 전문가 포럼서 패널 발언… 300mm 테스트베드·공동 FAB 강조시스템 반도체 전문기업 네패스가 국내 첨단패키징 산업 생태계 구축을 위한 전략적 방향을 제시했다. 네패스 김종헌 부사장은 지난 23일 서울 롯데호텔에서 개최된 ‘반도체 첨단패키징 전문가 포럼’에서 “기술적 후발주자라는 현실을 장점으로 전환해야 한다”며 “산업 전반의 기술과 역량을 결집할 수 있는 국가 주도의 오픈 이노베이션 플랫폼이 절실하다”고 강조했다.이번 포럼은 나노종합기술원(NNFC)이 주최하고 산·학·연·정 전문가 30여 명이 참석한 가운데, AI·HPC 확산에 따른 첨단패키징 인프라 확보 방안을 모색하기 위해 마련됐다. 국내외 반도체 생태계가 전공정 중심에서 후공정 기술로 무게중심이 이동하는 가운데, 패키징 기술의 전략적 중요성이 새롭게 조명됐다.이날 토론에서는 김 부사장을 비롯해 현대차증권, 앰코코리아, 한국전자기술연구원, 한국팹리스산업협회 등 업계 관계자들이 참석해 △첨단패키징 기술 전략 △글로벌 인프라 벤치마킹 △민관 협력 모델 구축에 대해 심도 있는 논의를 이어갔다.한편, 정부는 과학기술정보통신부 주관으로 2029년까지 300mm 웨이퍼 기반 첨단 패키징 장비·공정을 확보하고, 이를 개방형 플랫폼으로 운영하는 ‘반도체 첨단 패키징 인프라 구축 지원사업’을 추진 중이다.
2025-05-26 -
 네패스, 정부 주관 ‘혁신 프리미어 1000’ 기업 선정
네패스, 정부 주관 ‘혁신 프리미어 1000’ 기업 선정네패스가 정부가 주관하는 ‘2025년 제1차 혁신 프리미어 1000’에 선정됐다.‘혁신 프리미어 1000’은 금융위원회를 포함한 13개 정부 부처가 공동으로 운영하는 프로그램으로, 혁신성과 성장 잠재력을 갖춘 중소·중견기업을 발굴해 정책금융기관과의 연계를 통해 맞춤형 금융·비금융 지원을 제공하기 위해 마련됐다.각 산업별 주무 부처와 정책금융기관의 협업을 통해 총 509개 기업이 최종 선정되었으며, 네패스는 산업통상자원부의 반도체·디스플레이 부문에서 명단에 포함되었다. 네패스는 첨단 패키징 기술력, AI 반도체 대응 역량, 글로벌 고객 기반 확대 성과 등에서 우수한 평가를 받은 것으로 알려졌다.한편, 혁신 프리미어 프로그램은 오는 2026년부터 매년 1,000개 기업을 대상으로 지원을 확대해 나갈 예정이며, 이번 1차 선정 기업은 2026년 말까지 집중적인 정책 지원 대상에 포함된다.
2025-05-20 -
 네패스 - 인하대학교 제조혁신전문대학원 반도체 전문인력양성 협력 업무 협약 체결
네패스 - 인하대학교 제조혁신전문대학원 반도체 전문인력양성 협력 업무 협약 체결지난 4월 29일 인하대학교에서 네패스가 인하대학교 제조혁신전문대학원과 반도체 전문인력양성 협력을 위한 협약을 체결했다. 이날 체결식에는 네패스, 하나마이크론, 샘씨엔세스, 와이씨, 엑시콘, 대덕전자 등 반도체 산업의 관련자 7명이 참석하였다. 이번 업무협약 체결로 인하대는 네패스의 신규 인력 양성, 재직자 연구개발 인력 양성, 실무역량 강화 교육으로 이어지는 반도체 산업 지능화 전주기, 패키지 전문 인력 양성 및 반도체 인프라 활용 인력 전문화 등 인력 양성의 체계적인 협력을 위해 오는 2031년까지 반도체 공정 지능화융합전공 석사 과정 전문 인력을 국비 지원을 통해 양성하기로 했다.
2025-05-02 -
![[보도]네패스, 첨단 패키징 기술로 보급형 엣지 컴퓨팅 시장 공략 - 시사저널e 썸네일](https://www.nepes.co.kr/data/bbsData/17442476949.jpg) [보도]네패스, 첨단 패키징 기술로 보급형 엣지 컴퓨팅 시장 공략 - 시사저널e
[보도]네패스, 첨단 패키징 기술로 보급형 엣지 컴퓨팅 시장 공략 - 시사저널e[시사저널e=고명훈 기자] 반도체 후공정(OSAT) 전문기업 네패스가 팬아웃(FO) 공정을 기반으로 한 첨단 패키징 기술로 보급형 엣지 컴퓨팅 시장을 공략한다. RDL(재배선) 인터포저와 실리콘 브릿지 등 기술을 토대로 2.5D 패키징, 칩렛 시장 등을 공략할 계획이다.강인수 네패스 반도체연구소장(전무)은 2일 수원 컨벤션센터에서 열린 ‘첨단 전자실장 기술 및 시장 동향 세미나’에서 “지금 온디바이스(엣지) AI를 얘기하지만, 실질적으로 거기에 적합한 알고리즘이 엣지 컴퓨팅으로 전환까지는 안 된 것 같다”며 “앞으론 추론하는 AI 시장이 학습 시장보다 10배는 더 커질 것으로 예상되는데, 이는 바꿔 말하면 아직 우리가 누릴 수 있는 AI 시장은 오지 않았다는 것”이라고 설명했다.그러면서 “진정한 AI 시대는 보급형 엣지 컴퓨팅으로의 전환이 됐을 때 올 것이라고 생각하고, 그 시대를 준비해야 한다”고 덧붙였다.-하략-[기사원문보기 = 네패스, 첨단 패키징 기술로 보급형 엣지 컴퓨팅 시장 공략 - 시사저널e ]
2025-04-10 -
![[보도]청주시-㈜네패스, 고성능 첨단 반도체 생산시설 증설 투자협약 체결 썸네일](https://www.nepes.co.kr/data/bbsData/17433868169.jpg) [보도]청주시-㈜네패스, 고성능 첨단 반도체 생산시설 증설 투자협약 체결
[보도]청주시-㈜네패스, 고성능 첨단 반도체 생산시설 증설 투자협약 체결청주시는 충청북도와 시스템 반도체 첨단 패키징 전문기업인 ㈜네패스의 1천600억원대 규모 투자협약을 체결했다고 28일 밝혔다. 협약은 지난 27일 진행됐다.㈜네패스는 시스템 반도체 첨단 패키징 분야에서 글로벌 경쟁력을 갖춘 중견기업이다. 이번 협약을 통해 고성능 AI 반도체 수요증가에 대응하기 위한 생산시설을 오창읍 오창2공장에 증설 투자할 계획이다.증설로 인해 ㈜네패스는 AI 데이터센터용 반도체 패키징, 칩렛(2.5D, 3D)* 패키징 글로벌 공급 기업으로 자리매김할 전망이다. *칩렛(Chiplet) : 단일 칩을 여러 개의 소형 모듈화된 칩으로 나누어 설계 및 제조하는 기술. AI 반도체와 HBM(고대역폭메모리)을 하나의 패키지로 집적하는데 주로 사용.청주시는 기업이 안정적으로 사업을 추진할 수 있도록 적극적으로 지원하고, ㈜네패스는 신규 고용 시 지역민 우선 채용, 지역 건설업체 참여, 지역 자재 구매 등을 통해 지역경제 발전에 적극 동참할 예정이다.시 관계자는 “이번 네패스의 투자를 통해 청주는 첨단 반도체산업 중심지로서 위상이 한층 더 공고해질 것”이라며 “사업이 원활히 추진되도록 관련 지원을 아끼지 않겠다”고 말했다.이병구 ㈜네패스 대표이사는 “데이터센터, 자율주행, 휴머노이드 로봇 등 AI용 반도체 수요증가에 적극 대응해 K반도체 클러스터 생태계를 구축하고, 글로벌 반도체 시장에서 더 큰 성장을 이룰 것”이라며 “지역사회와 상생해 지역경제 활성화에도 기여하겠다”고 말했다.청주시-㈜네패스, 1600억 ‘투자 협약’…AI 반도체 생산시설 확장 | Save Internet 뉴데일리충북도·청주시, 네패스와 1천600억원 규모 투자협약 | 연합뉴스
2025-03-31 -
 네패스, 2025 대한민국 채용박람회 참석해 기업 소개... '우수 인재' pool 확보
네패스, 2025 대한민국 채용박람회 참석해 기업 소개... '우수 인재' pool 확보최상목 대통령 권한대행 부총리 겸 기획재정부 장관이 네패스 부스를 찾아 설명을 듣고 있다.네패스가 서울 양재 aT센터에서 19일부터 20일까지 이틀간 개최된 '2025 대한민국 채용박람회'에 참가했다. 이번 박람회는 고용노동부와 기획재정부, 중소벤처기업부, 대한상공회의소, 한국경제인협회, 한국경영자총협회 등이 공동 주최하며, 각 부처가 모집한 주요 분야별 120여 개 기업이 참석했다.네패스는 월드클래스 관에 마련된 부스에서 이틀간 약 200명의 구직자를 대상으로 채용 상담 및 면접을 진행하였다. 특별히, 개막식 이후 최상목 대통령 권한대행을 비롯한 각 부처 장관들이 네패스 부스를 방문해 기업 및 기술 소개를 듣는 시간을 가졌다.네패스 인사 담당자는 "청년 구직자들과 주요 정부 부처에 네패스를 알리는 좋은 기회가 되었다."라며, "금번 인재 풀(pool) 확보로, 추후 반도체 공정 엔지니어 대규모 채용 진행 시 도움이 될 것으로 기대한다."라고 말했다.
2025-03-24 -
![[네패스야하드] 제 15기 정기주주총회 소집공고 썸네일](https://www.nepes.co.kr/data/bbsData/17418540899.gif) [네패스야하드] 제 15기 정기주주총회 소집공고
[네패스야하드] 제 15기 정기주주총회 소집공고제 15 기 정기주주총회 소집공고 삼가 주주님의 건승과 댁내의 평안을 기원합니다. 상법 제365조에 의하여 제15기 정기주주총회를 아래와 같이 소집하오니 참석하여 주시기 바랍니다. - 아 래 – 1. 일시 : 2025년 03월 28일(금) 오전 10시 40분 2. 장소 : 충북 괴산군 연풍면 수옥정길 175-1 웨스트오브가나안 회의실 3. 회의목적사항 가. 보고사항 : 영업보고 나. 부의안건 n 제1호 의안 : 제15기(2024.01.01.~2024.12.31.) 재무제표 승인의 건 n 제2호 의안 : 이사 선임의 건 n 제3호 의안 : 이사 보수 한도액 승인의 건 n 제4호 의안 : 감사 보수 한도액 승인의 건 2025년 03월 13일 주 식 회 사 네 패 스 야 하 드 대 표 이 사 이 병 구 (직인생략)
2025-03-13 -
![[보도]네패스 코코아팹, `24년도 디지털새싹`사업 성료 및 우수 프로그램 선정 썸네일](https://www.nepes.co.kr/data/bbsData/17405324919.jpg) [보도]네패스 코코아팹, `24년도 디지털새싹`사업 성료 및 우수 프로그램 선정
[보도]네패스 코코아팹, `24년도 디지털새싹`사업 성료 및 우수 프로그램 선정반도체·인공지능 전문기업 네패스(대표 이병구)의 디지털 교육브랜드 '코코아팹'이 2024년 디지털새싹 교육을 성황리에 마쳤다고 밝혔다. 2022년부터 3년 연속 디지털새싹 사업을 수행한 코코아팹은 2024년에도 디지털새싹 운영기관으로 활동하며 디지털교육 강화에 크게 기여하였다.디지털새싹은 교육부와 17개 시·도교육청, 한국과학창의재단이 추진하는 디지털 인재양성 사업으로 전국의 초·중·고등학생들에게 소프트웨어(SW)와 인공지능(AI) 등 수준 높은 디지털 교육 기회를 제공하고 지역 및 학교 간 교육격차 해소를 위해 마련되었다.코코아팹은 2024년 3월부터 2025년 2월까지 서울·인천 지역의 300여 개 학교, 7,600여 명의 초·중·고등학생을 대상으로 차별화된 소프트웨어 및 인공지능 교육을 제공하였다. 특히 중·고등학교 모집인원을 대폭 늘려 약 51%의 중·고등학생이 참여했으며, 40여 개의 인공지능 선도학교와 도서 벽지 학교의 특수성을 고려하여 거점형 교육을 추가 개설해 약 600명의 학생들에게 새로운 디지털 학습 경험을 제공하였다.- 하략 - 출처: 네패스 코코아팹, `24년도 디지털새싹`사업 성료 및 우수 프로그램 선정 - 디지털타임스
2025-02-26 -
 네패스, 직책자 대상으로 MVC 워크샵 진행
네패스, 직책자 대상으로 MVC 워크샵 진행네패스가 지난 1월 14일, 15일 충북대학교 융합기술원에서 사내 직책자를 대상으로 Mission, Vision, Core Value(MVC) 워크샵을 진행하였다. MVC 워크샵은 네패스의 MVC 공감, 인식, 실천 총 세 가지 모듈로 나누어 진행되었으며, 미션·비전·핵심가치 이해를 통한 직책자들의 사명감 증진, 조직의 일체감 강화 및 시너지 극대화, 구체적 행동 실천을 통한 긍정적 직원 경험 강화를 목표로 하였다. 첫 번째 모듈 'MVC 현황진단' 차시에 워크샵 참가자들은 60가지 조직문화 특성 카드와 조별 토론을 통해 네패스의 조직문화를 진단하고 리더 간 공감대를 형성하였다. 두 번째 모듈 'MVC의 명확한 이해'에서는 뇌과학 전문가 이민주 겸임교수의 특강을 들으며 네패스의 3.3.7. Life가 개인과 조직에게 가져오는 긍정 효과를 배우고, 네패스 경영설계도 강의로 네패스의 경영이념을 되새기는 시간을 가졌다. 마지막 'Action Item 도출' 모듈에서는 강의 내용의 구체적 실천을 위한 Work way 및 일터에서의 사명선언문을 작성하였다. MVC 워크샵에 참여한 한 네패스 직책자는 "미션 비전 핵심가치에 대하여 파트원들과 나눠보고자 한다"며, "파트원들을 전적으로 믿어주며 업무 선택의 폭을 넓혀주고 배려와 칭찬 등 소통을 많이 하겠다"는 포부를 밝혔다. 또 다른 참석자는 "집단지성을 경험할 수 있게 함께 시너지를 낼 수 있는 방법을 찾겠다"는 목표를 나누었다.
2025-01-23
IR
GLOBAL TOP-TIER PARTNER, NEPES

![[보도]안정호 네패스 부사장 “모두를 위한 AI 교육 환경 조성해야” [AI리더스 2025] - 조선일보 이미지1](https://www.nepes.co.kr/data/bbsData/17683767459.jpg)










![[보도]네패스 디지털 교육 활성화 기여, 2년 연속 교육부 장관 표창 수상 - 디지털타임즈 이미지1](https://www.nepes.co.kr/data/bbsData/17368230239.jpg)


![[DIC2024] 김종헌 네패스 “FO 패키징 ‘생산증가 원가절감’…韓 디자인-패키징 공급망 강화해야” 이미지1](https://www.nepes.co.kr/data/bbsData/17461609899.jpg)
![[뉴스]네패스, ISMP 2024 참가 이미지1](https://www.nepes.co.kr/data/bbsData/17307866199.png)


![[보도]네패스 "2.5D 첨단 패키징으로 AI 반도체 시장 공략" 이미지1](https://www.nepes.co.kr/data/bbsData/17243815749.jpg)






![[보도]네패스, AI 시대 겨냥 고성능 패키지 기술 개발 이미지1](https://www.nepes.co.kr/data/bbsData/17138335509.jpg)
![[보도][인터뷰] “패키지 핵심 기술로 AI 반도체 시장 공략” 이미지1](https://www.nepes.co.kr/data/bbsData/17133309399.jpg)


![[보도]네패스, 지멘스EDA 솔루션으로 3D 패키징 이미지1](https://www.nepes.co.kr/data/bbsData/17098738449.png)


![[보도]네패스 디지털 교육 활성화 기여, 교육부 장관 표창 수상 이미지1](https://www.nepes.co.kr/data/bbsData/17036449079.jpg)






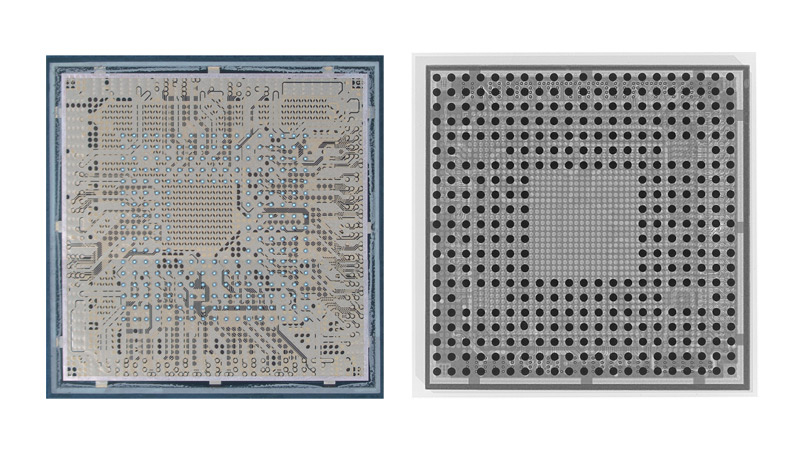

![[보도]이스라엘 AI아버지·K반도체 전격 의기투합 이미지1](https://www.nepes.co.kr/data/bbsData/16805747669.jpg)




















![[테크코리아 우리가 이끈다]네패스 - 전자신문 이미지1](https://www.nepes.co.kr/data/bbsData/16635505429.jpg)




![[반도체 패키징데이 2022]네패스, FO-PLP 적용 영역 확대 - 전자신문 이미지1](https://www.nepes.co.kr/data/bbsData/16571787239.jpeg)


![[보도자료]네패스, 미국 반도체 혁신 연합(ASIC) 가입… 글로벌 반도체 협력 강화 이미지1](https://www.nepes.co.kr/data/bbsData/16557778409.jpg)


![[보도] ㈜네패스, 폴리텍대 청주캠에 반도제 훈련 장비 기증 -충청일보 이미지1](https://www.nepes.co.kr/data/bbsData/16541327949.jpg)

![[보도]반도체 업계 “미세공정 한계, 패키징 기술 대안” 이미지1](https://www.nepes.co.kr/data/bbsData/16539562229.jpg)

![[보도]괴산군 청안면주민자치위원회, ㈜네패스아크와 자매결연 협약 이미지1](https://www.nepes.co.kr/data/bbsData/16530083659.jpg)



![[보도]반도체 지네발 없앴던 네패스 “반도체 패키징 효율 10배…3년 내 매출 1조원 달성” 이미지1](https://www.nepes.co.kr/data/bbsData/16505874909.jpg)
![[보도]이병구 네패스 회장 "반도체, 사각형으로 패키징…생산성 10배 높여" 이미지1](https://www.nepes.co.kr/data/bbsData/16505873269.jpg)

![[보도]우리 지역 글로벌 기업/2. 첨단 파운드리 인프라 확장해가는 (주)네패스 이미지1](https://www.nepes.co.kr/data/bbsData/16466976519.jpg)

![[보도]반도체 투자 활성화를 위한 기업 간담회 개최 이미지1](https://www.nepes.co.kr/data/bbsData/16450737419.jpg)


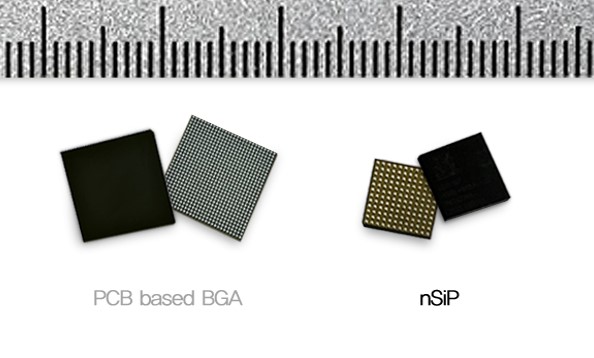


![[보도][Issue&Biz] 인공지능·빅데이터 도입…반도체공정 혁신 씨앗 심었다 이미지1](https://www.nepes.co.kr/data/bbsData/16408506559.jpg)
![[보도]충북대, 네패스의 반도체 및 IT 분야 인력 양성에 앞장 이미지1](https://www.nepes.co.kr/data/bbsData/16406768519.jpg)
![[보도]백악관도 극찬한 韓 반도체 기업…서로 존중하는 ‘슈퍼스타 경영’의 힘 이미지1](https://www.nepes.co.kr/data/bbsData/16403127989.jpg)



![[보도][제58회 무역의 날] 2억불 탑 (주)네패스 이미지1](https://www.nepes.co.kr/data/bbsData/16387707239.jpg)


![[보도][지역특화 스마트IT산업, AI융합엔진 장착] 반도체패키징·태양광 전문기업 데이터 경영 활성화 이미지1](https://www.nepes.co.kr/data/bbsData/16376595039.jpg)

![[보도][2021 독서경영 우수직장-최우수상]네패스 이미지1](https://www.nepes.co.kr/data/bbsData/16360020649.jpg)

![[보도] 반도체 패키징 첨단기술, 백악관도 찍었다 이미지1](https://www.nepes.co.kr/data/bbsData/16336551869.jpg)
![[보도]네패스, 차세대 패키징 'FO-PLP' 양산 개시…PMIC '세계 최초' 이미지1](https://www.nepes.co.kr/data/bbsData/16333950019.jpg)
![[보도] 네패스, 전통적인 웨이퍼 레벨 패키징서 한걸음 진보 이미지1](https://www.nepes.co.kr/data/bbsData/16330486029.jpg)

![[보도]반도체 초강국 이끌 '최상위 협의체' 출범 이미지1](https://www.nepes.co.kr/data/bbsData/16328146139.jpg)
![[보도]'1000억 투자' 네패스그룹, 삼성전자 협업 강화 '시그널' 이미지1](https://www.nepes.co.kr/data/bbsData/16318463439.jpg)

![[보도] [글로벌테크코리아 2021] 김종헌 네패스 CTO "차세대 패키징 기술 상용화 박차" 이미지1](https://www.nepes.co.kr/data/bbsData/16310576999.jpg)




![[보도] “네패스, 반도체 후공정인 패키징 및 테스트 기술력 보유” -뉴스투데이 이미지1](https://www.nepes.co.kr/data/bbsData/16291595169.jpg)
![[보도]첨단 반도체 패키징 기술 무장 '네패스' -전자신문 이미지1](https://www.nepes.co.kr/data/bbsData/16276038749.jpg)










![[보도] “초소형-고성능 패키징 기술로…韓 반도체 판도 바꿀 것” - 동아일보 이미지1](https://www.nepes.co.kr/data/bbsData/16196720229.jpg)
![[보도]「基板なし」が主流に 기판 공급 부족 "대란" - 日 Daily NNA 이미지1](https://www.nepes.co.kr/data/bbsData/16196608579.png)
![[보도] 폴리텍 청주캠 - 네패스 맞춤형 인력양성 업무 협의-충청타임즈 이미지1](https://www.nepes.co.kr/data/bbsData/16194047609.jpg)




![[보도]Employee-centered management drives success-The Korea Times 이미지1](https://www.nepes.co.kr/data/bbsData/16184755729.jpg)
![[보도]네패스, 반도체 총괄 회장에 정칠희 삼성전자 고문 영입 이미지1](https://www.nepes.co.kr/data/bbsData/16152477089.jpg)

![[보도]이병구 네패스 회장 "동서고금 기업 경영의 핵심은 '사람의 마음'이죠"-한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16121410139.jpg)
![[보도]네패스, '시스템인패키지(SiP)' 신기술 공개 -한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16118772609.jpg)
![[보도]High-tech parts suppliers to watch in 2021-The Korea Times 이미지1](https://www.nepes.co.kr/data/bbsData/16099940859.jpg)
![[보도]新기술에 굶주린 반도체 패키징 강자…적자 때도 2000억 투자 -한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16098368659.jpg)
![[보도]고급 패키징 수요 급증…年 평균 13% 성장 -한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16100019849.jpg)



![[보도] 뉴로모픽칩 하이엔드 CCTV 많이 채용-전파신문 이미지1](https://www.nepes.co.kr/data/bbsData/16052562179.jpg)
![[보도]'테스트 전문가' 네패스아크, 韓 시스템반도체 성장 이끈다 이미지1](https://www.nepes.co.kr/data/bbsData/16052561219.jpg)
![[보도]한동대, 네패스와 반도체 및 AI산학 협력 협약 이미지1](https://www.nepes.co.kr/data/bbsData/16052551689.jpg)
