-
 NEWS
NEWS
-
 네패스, AI반도체 패키징 기술 상용화 추진
네패스, AI반도체 패키징 기술 상용화 추진네패스가 인공지능(AI) 및 첨단 반도체에 필요한 차세대 패키징 PoP(Package on Package) 기술을 개발하고 국내외 칩 제조사들과 협력하며 상용화에 힘을 쏟고 있다.최근 AI 용 패키지 시장이 대만 기업들의 과점으로 Global 공급망에 어려움을 겪고 있는 가운데, 네패스는 2.5D 패키징*의 기반 기술인 PoP 기술을 자사의 강점인 재배선(RDL) 기술을 활용해서 개발 완료하고 상용화를 추진 중에 있다.주*2.5D 패키징: 넓은 기판 모양의 인터포저 위에 반도체 다이(Die)를 수평 매치하는 기술로 AI 반도체와 HBM(High Bandwidth Memory)을 하나의 패키지로 집적하는데 주로 사용된다..네패스가 개발 중인 2.5D 패키징은 고가의 실리콘(Si) 인터포저 대신, 팬아웃 공정을 활용한 재배선(RDL) 인터포저를 구현함으로 가격 경쟁력과 small form factor의 강점을 가지고 있다.특히 이번에 개발한 PoP 기술은 반도체 소자 내장(Embedding) 기술, 양면 재배선(RDL)기술, 수직신호연결(Vertical Interconnection) 등의 요소 기술을 포함하고 있어, 스마트폰 및 자동차용 AP(Application Processor), Wearable sensor, 그리고 AI 반도체 등으로 사용처를 확장해 나갈 수 있는 첨단 패키징의 기본 플랫폼 기술이다.네패스 CTO 김종헌 실장은 “자율주행 자동차 핵심기술인 라이다(LiDAR) 센서 제조업체인 일본의 Global 반도체 업체로부터 우수한 성능을 인증받아 제품 적용을 협의중에 있으며, 한편 미국 및 유럽 고객의 의료 장비 및 보청기용으로도 사업화를 활발하게 논의 중이라고 말했다. 이어 김종헌 실장은 이번에 개발한 PoP 기술을 기반으로 AI 반도체용 2.5D 패키징 기술에 집중해서 25년 상반기에는 고객과 함께 개발을 완료하고 하반기부터는 양산을 목표로 하고 있다고 밝혔다.네패스는 차세대 성장을 견인하는 전략시장으로, AI 서버, 자동차, 엣지 컴퓨팅(Edge Computing) 제품 고객과 적극 협업하여 2025년 하반기부터 2.5D, PoP 기술 상용화에 본격 진입한다는 목표를 제시했다.보도자료 문의: pr@nepes.co.kr
2024-05-20 -
 네패스 이병구 회장, 로고스경영인대상 수상
네패스 이병구 회장, 로고스경영인대상 수상네패스 이병구 회장이 나눔 및 감사 경영을 통한 가치 창출 활동의 공적을 높이 평가받아 로고스경영인대상을 받았다. 시상은 지난 5월 11일 한양대학교에 열린 로고스경영인대상 시상식에서 이루어졌으며 이병구 회장을 대신해 기업문화센터 이종욱 코치가 수상했다. 본 시상식을 주관한 한국로고스경영학회는 학문을 통한 나눔과 섬김을 추구하는 경영학자 및 경영인 학회로, 국가와 지역사회의 발전, 그리고 글로벌 삶의 균형을 위한 이병구 회장의 노력을 기념하고자 본 상을 수여했다고 밝혔다. 한편, 시상식 이후에는 이종욱 코치가 ‘네패스 경영과 기업 문화’라는 주제로 한국로고스경영학회 춘계국제학술대회 기조연설을 진행했다.
2024-05-16 -
 과기부 이창윤 차관, 코코아팹 청소년 디지털 교육 포로그램 '디지털새싹' 참관
과기부 이창윤 차관, 코코아팹 청소년 디지털 교육 포로그램 '디지털새싹' 참관지난 5월 9일, 네패스 교육사업팀이 운영하고 있는 청소년 디지털 교육사업 ‘디지털새싹’ 수업에 과학기술정보통신부 이창윤 차관을 비롯해 교육부, 한국과학창의재단 관계자 30여 명이 참관하였다.‘디지털새싹’ 사업은 교육부와 17개 시도교육청, 한국과학창의재단이 추진하고 있는 디지털 인재양성 교육사업으로, 네패스 디지털 교육 브랜드 ‘코코아팹’이 3년 연속 성황리에 운영해오고 있다.이날 수업은 서울여자중학교에서 진행되었으며, 네패스 코코아팹의 교육 소개와 함께 교육적 성과를 공유하고, 실제 현장에서 진행되는 수업을 참관하는 순서로 진행되었다.네패스 코코아팹은 올 상반기 ‘디지털새싹’ 사업을 통해 2,100여 명의 초, 중, 고등학생들에게 차별화된 디지털 교육을 선보일 계획이며, 그동안 축적해온 노하우를 바탕으로 최근 정부에서 본격화하고 있는 디지털 기반의 교육혁신 사업에 적극 참여하여 활동 분야를 더욱 넓혀갈 예정이다.
2024-05-10 -
![[보도]네패스, AI 시대 겨냥 고성능 패키지 기술 개발 썸네일](https://www.nepes.co.kr/data/bbsData/17138335509.jpg) [보도]네패스, AI 시대 겨냥 고성능 패키지 기술 개발
[보도]네패스, AI 시대 겨냥 고성능 패키지 기술 개발업계 최초 8 레이어 재배선 인터포저 개발기판 없이 패키징 가능···전체 칩 사이즈 줄여줘네패스의 청주2캠퍼스 / 사진=네패스[시사저널e=고명훈 기자] 국내 반도체 후공정(OSAT) 전문기업 네패스가 반도체 2.5D 패키징 기술에 주력하며 반도체 크기를 줄일 수 있는 핵심 부품 기술을 개발했다. 네패스는 첨단 패키지 시장 선점을 가속한단 계획이다. 2.5D 패키징은 반도체 성능 향상과 발열 통제에 효과적이어서 인공지능(AI) 산업의 고도화에 따라 주목받는 패키징 기술이다.22일 반도체업계에 따르면 네패스가 개발 중인 2.5D 패키징의 핵심 부품은 ‘재배선(RDL) 인터포저’다. 반도체 칩렛과 서브스트레이트(기판) 회로 사이에 추가로 들어가는 또 하나의 새로운 미세회로 기판으로, 중간에서 칩렛과 기판의 회로를 전기적으로 연결해주는 역할을 한다.재배선 인터포저는 고분자 물질과 구리 배선으로 구성된 재배선 층으로 이뤄진다. 네패스는 재배선 층수에서 현재 일반적으로 쓰이는 6 레이어(Layer, 층) 외에도 업계 최초 8 레이어 기술을 개발 중이다. 기존의 6 레이어 구조에선 기판을 따로 사용해야 했다면, 8 레이어의 경우 기판 없이 패키징이 가능하므로 전체 패키지 크기를 줄일 수 있다. 또, 별도의 조립 과정을 거치지 않아도 돼 효율성이 높다.강인수 네패스 반도체연구소장(전무)은 “RDL 층수에서 가장 일반적으로 알려진 것이 6 레이어인데 8 레이어까지 개발하고 있다”며 “레이어 수가 늘어났단 건 그라운드 레이어를 중간에 추가로 집어넣는 형태인데, 이러면 위층과 아래층의 배선 간 간섭을 없앨 수 있다”라고 설명했다.그러면서 “현재 8 레이어를 하는 업체는 전 세계 어디에도 없는 것으로 안다”라고 부연했다.재배선 인터포저는 기존 2.5D 구조 패키징에서 주로 쓰이던 실리콘(Si) 기반의 인터포저 대비 비용을 획기적으로 줄일 수 있단 장점을 지닌다. 두 제품의 가격 차이는 10분의 1 수준인 것으로 전해진다.네패스가 재배선 인터포저 개발에 자신하는 이유는 웨이퍼레벨패키지(WLP) 분야에서 확보한 오랜 업력에 있다. WLP는 최종 가공을 마친 웨이퍼 상태에서 재배선, 범핑 공정 등을 하는 첨단 패키지 기술로, 패키지 크기를 줄이고 제조 비용을 절감할 수 있단 장점이 있다.네패스의 WLP(웨이퍼레벨패키지) 솔루션 / 사진=네패스네패스는 양산 수준의 팬아웃(FO)-WLP 기술을 보유한 업체로 알려져 있다. 지난해 산업통상자원부가 발표한 ‘2023년 세계일류상품 및 생산기업’ 선정 수여식에서 회사의 WLP 기술이 ‘현재 세계일류상품’에 선정되기도 했다.강 전무는 “현재 2.5D에 쓰이는 실리콘 소재의 인터포저는 좋긴 하지만 상당히 비싸서 미래에는 재배선 인터포저로 넘어가려는 추세”라며 “RDL 인터포저는 사실 WLP에서 나온 용어였고, TSMC도 CoWoS 패키지 기술에 실리콘 인터포저 대신 RDL 인터포저를 쓰겠다고 ‘CoWoS-R’이라고 이름을 붙인 것처럼 일반적으로 전 세계에서 많이 쓰는 제품”이라고 설명했다.네패스는 내달 미국 콜로라도주 덴버에서 개최되는 ‘전자 부품 및 기술 컨퍼런스ECTC) 2024’에서 8 레이어 재배선 인터포저 기술 관련 발표할 계획이다. ECTC는 패키징, 전자 부품 등 영역에서 및 기술 교류의 장이 펼쳐지는 국제 권위의 행사로, 네패스는 FO와 WLP, 패널레벨패키지(PLP) 등 패키징 기술 세션에서 회사의 RDL 인터포저 관련 기술 개발 현황을 공유할 예정이다.-하 략-원문보기 https://www.sisajournal-e.com/news/articleView.html?idxno=402241
2024-04-23 -
![[보도][인터뷰] “패키지 핵심 기술로 AI 반도체 시장 공략” 썸네일](https://www.nepes.co.kr/data/bbsData/17133309399.jpg) [보도][인터뷰] “패키지 핵심 기술로 AI 반도체 시장 공략”
[보도][인터뷰] “패키지 핵심 기술로 AI 반도체 시장 공략”강인수 네패스 반도체연구소장RDL 인터포저·실리콘 브릿지 기술로 AI 학습·추론용 칩 패키징강인수 네패스 반도체연구소장(전무) / 사진=고명훈 기자[시사저널e=고명훈 기자] “후공정 기술로 AI 시대 학습용 칩과 추론용 칩 분야를 모두 공략할 것입니다. ”반도체 후공정업체 네패스가 인공지능(AI) 반도체 패키징 시장에 뛰어든다. 시스템반도체 분야에서 후공정 기술을 개발해온 네패스는 AI 반도체 시대에 맞는 후공정 기술로 시장 공략에 나섰다.15일 강인수 네패스 반도체연구소장(전무)은 “AI 반도체는 대량의 데이터를 훈련하는 학습용 칩과 알고리즘 공식이 들어간 ‘엣지 컴퓨팅(추론용 칩) 시장으로 구분할 수 있으며 양 시장을 모두 공략하려고 한다”고 말했다.네패스가 개발한 기술은 재배선(RDL) 인터포저와 실리콘 브릿지 분야다. RDL 인터포저는 반도체 회로와 기판 회로를 사이 새 회로를 구성하는 부품이다. 2D 구조의 칩렛과 기판 사이에 해당 부품을 끼워 넣는 방식이어서 2.5D 패키징 기술로 불린다. RDL 인터포저가 들어간 2.5D 패키지 구조 / 이미지=IEEE 2019 전자부품 및 기술 컨퍼런스 자료네패스는 지난해 ‘2023년 세계일류상품 및 생산기업’ 선정 수여식에서 웨이퍼 레벨 패키징(WLP) 기술이 ‘현재 세계일류상품’에 선정된 바 있다. 해당 기술에서 글로벌 시장 5위 안에 들거나 점유율 5% 이상을 차지하는 기업으로 인정받은 것이다. 지난해 ‘칩렛 이종 집적 초고성능 AI 반도체 개발’ 국책과제에 선정돼 연구개발을 이어가고 있다.강 전무는 “국내에서 팬아웃(FO)-WLP 기술을 양산하는 유일한 기업이다 보니 지난해 국책과제에도 선정돼 좋은 기회를 얻게 되지 않았나 생각한다”라고 말했다.다음은 강 전무와의 일문일답.-국내 대부분의 반도체 패키징 회사들이 메모리를 중심으로 하고 있는데, 네패스는 시스템반도체로 시작했다. 어떤 계기가 있었나우리는 메모리가 아니라 디스플레이구동칩(DDI)이란 컨슈머 제품으로 사업을 시작했다. 사업을 시작할 당시 모니터가 화면출력용 브라운관(CRT)에서 박막트랜지스터(TFT) 액정디스플레이(LCD)로 전환되면서 시기와 잘 맞물렸다고 볼 수 있겠다. LCD 패널은 반도체로 구동해줘야 해서 칩들이 들어가야 하는데, 기존 전통적인 방식의 와이어본딩이 아니라 WLP 공법을 써서 하는 것이었다. 또, LCD에서 유기발광다이오드(OLED)로 넘어가면서 모니터 안에 들어가는 DDI가 10개 이상이 되다 보니 시장이 성장세를 타고 있었다. 연구개발(R&D)과 거래선과의 긴밀한 협업을 통해 WLP 기술에 좀 더 집중했다.네패스의 청주2캠퍼스 / 사진=네패스-네패스의 WLP 기술력이 글로벌에서 어느 정도 수준인가처음 스마트폰이 나올때 반도체 부품이 20개 정도에 불과했다면 지금은 100~200개 사이라고 봐야 한다. 한정된 체적(입체가 차지하는 공간 크기)에 반도체 부품을 계속 늘려야 하는 상황인데 그러려면 부품은 더 작아져야 한다. 현존하는 기술 중 칩을 가장 작게 만들 수 있는 패키지가 WLP였던 것이다. 열심히 연구해서 다양한 크기의 디바이스에 WLP를 적용했던 연구 데이터들을 모아서 2009년 국제 WLP 컨퍼런스인 ‘IWLPC’에서 발표했는데 베스트 어워드를 수상하게 됐다. 회사를 많이 알리는 계기가 됐다.글로벌 회사들과 직접 비교해도 기술력은 우리가 밀리지 않는다고 생각한다. 다만 규모의 차이는 있다. 그쪽은 우리에게 없는 기존의 전통 패키지들을 어마어마한 규모로 갖고 있다. 우리는 WLP에 중점을 두고 있다. 글로벌 기업들이 모든 디바이스를 고르게 다 할 수 있다면, 우리는 스마트폰에 특화된, 또는 자동차에 특화된 고객사들이 찾는 것이다. 이런 고객사 입장에서 종합반도체를 지향하는 패키지 업체에서 하나만 빼 진행하는 것보다는 특정 분야를 더 잘하는 우리 같은 기업이 편할 것이다. 또 예상치 못한 상황에 대비해 플랜B를 갖춰야 하는 점도 있을 것이다.-네패스는 WLP의 차세대 기술인 FO 기술에도 집중하고 있다공법이 발전할수록 칩 사이즈는 줄어든다. WLP와 일반 보드를 연결할 때 그 위에 솔더볼을 배치하는데, 이때 솔더볼의 간격에는 일정한 규격이 정해져 있다. 결국 칩 하나에 솔더볼의 개수가 정해져 있는 건데, 이를 극복하기 위해 솔더볼을 칩 영역 외로 넘어가서 배치하는 것이 FO 기술이다. FO에서는 칩의 영역을 인위적으로 키우는 패널리제이션 공정이 추가된다.FO 패키징 방식은 기존 시스템반도체에서 메모리까지 앞으로 모든 영역에 다 쓰일 것이다. 특히, 메모리에서 어려운 점이 최적화인데, 패키지에서 솔더볼의 위치 규격이 정해져 있다 보니 다른 디바이스들과 합칠 때 제한이 있다. FO를 활용하면 솔더볼을 원하는 위치에 만들 수 있어 커스터마이즈가 가능하단 장점이 있다.-네패스는 패키징에 이어 자회사 네패스아크의 테스트 사업까지 후공정 전과정을 사업분야로 뒀다. 확실한 장점이 있을 것으로 보이는데후공정 분야 2.5D는 테스트 기술이 가장 어렵다. 신경계처리장치(NPU) 4개에 고대역폭메모리(HBM) 8개로 구성되다 보니 테스트 난이도가 굉장히 높은 것이다. 예전에 단순 전력반도체(PMIC)의 경우는 하나의 패키지라서 외관 검사만 해도 된다고 봤다. 그러나 점점 첨단 패키지로 가면서 테스트 솔루션 없이는 지금 얘기하는 첨단 패키지 개발도 어렵다고 본다. 테스트 영역과의 콜라보레이션이 굉장히 중요한 것이고, 패키지 회사에 테스트 전문 회사가 같이 있는 건 큰 이점이 된다. 우리도 정부로부터 국제과제에 선정되고 돌아와 가장 먼저 찾아간 곳이 네패스아크 연구소였다.-하 략-원문보기 https://www.sisajournal-e.com/news/articleView.html?idxno=402046
2024-04-17 -
 네패스, AI 반도체용 PMIC 대량 수주
네패스, AI 반도체용 PMIC 대량 수주네패스 반도체 사업부가 미국 시에틀에 본사를 둔 전력 반도체 전문 팹리스사로부터 AI서버용 저전력 PMIC를 대량 수주하여 공급을 확대한다고 밝혔다.8인치는 현재 월 3천장에서 2/4분기부터 2만장 규모로 늘리고, 12인치는 금년까지 월 1만 장 규모의 생산능력을 확보 후 내년까지 월 1만 5000장으로 확대할 계획이며 총 투자규모는 내년 말까지 약 600억-700억원 규모이다.특히, 12인치 제품은 주로 미국 최대 AI반도체회사 서버 시스템에 공급 될 예정인데, 시스템 한 대당 최대 3,000개의 PMIC가 들어가게 된다. 이에 따라 저전력 PMIC가 서버의 전력 효율을 극대화 시키는 기술로 크게 주목 받고 있는 가운데 네패스가 이 기술을 상용화 하는데 선도적으로 성공시킴으로 이번에 대량 수주를 하게 되었다.한편, 네패스 반도체사업부는 기존의 휴대폰용 PMIC 물량도 AI폰 성장에 힘입어 괄목할 만한 성장을 이어 가고 있고, 휴대폰 및 차량용 전장 제품에 OLED 채용이 늘어남에 따라 기존 사업도 견조한 성장세를 이어가고 있다.네패스 Corp.은 반도체 사업부와 전자재료 사업부가 있으며 반도체 사업부는 AI반도체 성장에 힘입어 올해 매출 3,500억원에서 가파른 성장세를 이어가 2026년에는 5,200억 원 이상의 매출을, 전자재료 사업부는 올해 매출 950억원에서 1,900억원이상 매출을 예상하고 있어 네패스 Corp.의 두 사업부 매출은 올해 4,450억 매출에서 2026년에는 7,100억원의 매출을 예상함으로 향후 2년간 가파른 성장을 이어갈 것으로 예상하고 있다.보도자료 문의: pr@nepes.co.kr
2024-04-15 -
 네패스, 반도체 HBM 도금액 국산화
네패스, 반도체 HBM 도금액 국산화네패스 전자재료 사업부(이정영 사장)는 전량 수입에 의존하고 있는 기능성 반도체 재료인 도금액을 오랫동안 자체 연구개발과 협업으로 국산화하여 2년전부터 초도 생산을 해오다 HBM용 TSV 공장에 채택됨으로 올해부터 본격 양산을 시작한다고 밝혔다.네패스가 국산화한 도금액은 미세 공정용으로 DDR-5 이후제품과 HBM등에 사용되는 도금액으로 그 성능과 공정성 그리고 제품의 균일성이 우수하여 10나노이하 미세공정에 특화된 제품으로 인정받고있다. 2024년 도금액 매출은 450억원 규모로 예상하며 매년 30-40% 이상의 높은 성장률을 기대하고 있다. 네패스 전자재료 사업부는 2024년 950억원 매출을 예상하고 있으며, 고성능 D램 반도체와 AI반도체의 성장에 비례해서 2026년 1,900억원 규모의 괄목할만한 매출 성장을 기대하고 있다.한편, 네패스는 도금액과 함께 핵심 기능성 재료 중 하나인 PSPI(Photosensitive Polyimide)도 화학연구소와 오랜동안 협업을 통해 1차개발을 완료하고 고객제품 특성에 맞게 조율하고 있는상태에 있다. 층간 절연물질인 PSPI 재료는 고온용(375 ℃)와 저온용(200도 ℃)이 사용되는데 그동안 특히 저온 제품은 특성이 좋아 대만의 몇개 업체에 샘플을 제공하기 시작했으며 곧 가시적효과가 나오기를 회사측은 기대하고 있다고 전했다. 주*) 반도체 재료는 기능성 재료와 공정용 재료로 구분되며, 기능성재료는 제품에 남아 제품 수명이 다 할 때가지 기능을 하는 재료로 Cu 도금액(Cu Plating), PSPI(Photosensitive Polyimide), 그리고 EMC(Epoxy Molding Compound) 3가지가 핵심이며, 대부분 수입에 의존하고 있는 고가의 재료이다.보도자료 문의: pr@nepes.co.kr
2024-04-04 -
![[보도]네패스, 지멘스EDA 솔루션으로 3D 패키징 썸네일](https://www.nepes.co.kr/data/bbsData/17098738449.png) [보도]네패스, 지멘스EDA 솔루션으로 3D 패키징
[보도]네패스, 지멘스EDA 솔루션으로 3D 패키징독일 반도체 설계자동화(EDA) 기업 지멘스EDA와 네패스가 첨단 패키징 경쟁력 강화를 위해 손을 잡았다.지멘스 EDA는 네패스에 3차원 반도체(3D IC) 패키지 개발을 위한 첨단 솔루션을 공급한다고 7일 밝혔다. 3D IC 패키지는 반도체 회로 미세화 한계를 극복하기 위한 첨단 패키징 기술 중 하나다. 여러 반도체를 수직으로 쌓아 데이터 연결 속도 등 성능을 높이고 전력 소모와 패키지 면적은 줄이는 것이 핵심이다.네패스는 3D 적층 SW, 인쇄회로기판 설계 검증 SW, 기판 통합 SW, 패키징 설계 SW 등 지멘스 EDA의 각종 첨단 솔루션 기술로 패키징 역량을 강화한다. 2.5D 및 3D 등 글로벌 수요가 수요가 급증한 칩렛 설계 서비스도 제공할 수 있게 됐다. -하 략-원문보기 : https://m.etnews.com/20240307000249
2024-03-08 -
 네패스, 인공지능용 패키징 시장 진출
네패스, 인공지능용 패키징 시장 진출Chat GPT 등 생성형 인공지능 시장의 폭발적인 성장으로 인해 인공지능 시스템에 사용되는 전력 반도체(PMIC)의 첨단 패키징 수요가 폭증하고 있다.네패스가 이번에 수주해서 양산 시작하는 제품은 AI 칩셋용 전력 반도체이며 향후 고성능 컴퓨팅(HPC), 자동차 시장으로 확장되는 첨단 PMIC 제품이다.네패스는 글로벌 팹리스 社(미국)의 전력 반도체 양산을 시작으로 글로벌 HPC 및 자동차 시장 진출의 교두보를 마련했다. 금번 유치한 신규 고객은 AI 제품분야 가치사슬에 속한 기업으로서 폭발적인 성장에 대비하고자 네패스와 전략적 파트너십을 갖고 협업해 나가고 있다.네패스는 자사 첨단 패키징 라인에서 해당 고객의 제품을 다수 개발 중에 있으며, 지난해 처음 출하한 전력 반도체는 GPU 및 CPU, 컨슈머, IoT 업체들의 AI 칩셋에 탑재된 것으로 확인된다. 해당 제품은 이후 자동차용 ADAS에도 채택 예정이어서 전방 시장 성장에 따른 추가적인 큰 폭의 물량 확대가 예상된다.또한 최근에 양사는 12인치 프로젝트 협업을 진행 중에 있으며, 향후 600mm PLP 공정을 적용한 제품 개발도 추진 예정이다. 제품과 공정을 다각화하며 시장 내 경쟁우위를 확보해 간다는 전략이다.최근 반도체 제조 기지의 탈 중국·대만화가 가속되고 있어 글로벌 칩메이커들과 네패스와의 전략적 파트너십은 더욱 견고해질 것으로 보인다. 네패스는 이를 기회로 시장 점유율을 높이고, 인공지능용 차세대 패키지인 2.5D/3D 역량을 지속 확보해갈 방침이다.네패스 관계자는 “현재 네패스는 스마트폰 시장을 중심으로 핵심 고객들을 보유하고 있는데, 금번 신규 고객과의 전략적 파트너십으로 성장성 높은 HPC 및 자동차 시장을 공략할 수 있게 되었다.”고 말하며, “산업 관점에서는 글로벌 팹리스 유치를 통해 국내에 첨단 패키징 인프라 강화 및 파운드리, 테스트 등 비메모리 제조 생태계의 구조적 성장에 기여할 수 있을 것.”이라고 전했다.
2024-02-26 -
![[보도][충북TP 희망이음] "반도체 기술력·경쟁력 갖춘 글로벌 기업" 썸네일](https://www.nepes.co.kr/data/bbsData/17083052249.png) [보도][충북TP 희망이음] "반도체 기술력·경쟁력 갖춘 글로벌 기업"
[보도][충북TP 희망이음] "반도체 기술력·경쟁력 갖춘 글로벌 기업"[지역기업-희망이음 특집](5)(주)네패스회사 전경(청주2캠퍼스)◆네패스, 시스템 반도체 분야 코스닥 상장기업 충북 음성군(본사)과 청주시에 소재한 (주)네패스(NEPES, 대표이사 이병구)는 반도체 핵심소재 및 첨단 패키징 서비스를 제공하는 시스템 반도체 후공정 전문기업이다.1990년 반도체·전자부품·화학제품 등의 제조 판매로 창립한 네패스는 반도체·디스플레이 미세회로 형성용 현상액 국산화에 성공했다.이어 2000년 시스템 반도체 시장에 도전해 시스템 반도체 플레이어가 희소한 국내 시장에서 팬아웃웨이퍼레벨패키지(Fan-out WLP), 팬아웃패널레벨패키지(Fan-out PLP) 등 첨단 기술 상용화를 기반으로 국내 시스템 반도체 생태계의 핵심 밸류 체인으로 성장해온 코스닥 상장기업이다.네패스는 반도체 비즈니스를 주력으로 하고 있으며 본사가 위치한 음성, 주요 반도체 팹이 위치한 청주와 괴산 등 국내 7개 사업장을 운영하고 있다. 또 해외에는 중국, 미국, 필리핀 등 5개 지역에서 반도체 생산라인과 영업 사무소를 운영한다.‘영원한 생명’이라는 뜻의 히브리어에서 유래한 회사명은 ‘강인한 생명력’과 ‘지속 가능한 성장’이라는 네패스의 비전을 담고 있다.네패스는 '땅끝까지 우리의 기술과 제품을 가지고 섬긴다'는 사명 아래 선진기술과 기업문화를 경쟁력을 삼아 글로벌 기업으로 발돋움하고 있다.네패스는 지난 2021년 백악관이 발표한 반도체 공급망 조사 보고서에서 삼성전자와 함께 글로벌 Top 10 첨단 패키징 기업으로 등재될 정도로 뛰어난 기술력을 보유하고 있다.수상 경력으로 2011년 대한민국 일하기 좋은 100대 기업 선정, 2020년 혁신기업 국가대표 1000 선정, 2021 충청북도 고용 우수기업 선정, 2022년 10대 등대기업(신시스템 분야) 선정, 2023년 네패스라웨, 세계 최초 PI 대체 팬아웃 패키지 기술 상용화에 이르기까지 다양하다. 기업 문화도 자랑거리다. 네패스는 음악교실, 감사진법, 마법노트, 3.3.7라이프 등 감사 경영을 기반으로 독특하고 다양한 프로그램은 구성원들의 건강한 자아 형성과 공동체 역량 강화로 성과창출로 이어지고 있다.특히 직원의 80% 이상을 지역 인재로 채용하고, 발달장애인으로 구성된 오케스트라 ‘루아’를 창단, 운영하는 등 ESG 경영을 통한 사회적 가치의 실현에도 앞장서고 있다.웨이퍼레벨패키지 제품◆출향 청년들의 지역 리턴 기회 마련네패스는 충북 출신 출향 청년을 대상으로 맞춤탕방을 진행했다. 탐방에는 충북학사 재사생(서울대, 고려대, 한양대 등 20명)이 참여했다. 이들 학생들의 전공은 경영학, 화학생명공학과, 교육학 등 다양하다.청주대학교 26명(경영학, 무역학과 등)도 맞춤탐방에 참여해 기업의 생산라인을 견학하고 채용에 대한 설명도 들었다.-하 략-원문보기 : https://www.thecm.net/news/articleView.html?idxno=49024
2024-02-19 -
![[보도]코코아팹, 디지털새싹 캠프 `코드히어로` 성공리에 마쳐… 겨울방학 캠프 개시 썸네일](https://www.nepes.co.kr/data/bbsData/17052799099.jpg) [보도]코코아팹, 디지털새싹 캠프 `코드히어로` 성공리에 마쳐… 겨울방학 캠프 개시
[보도]코코아팹, 디지털새싹 캠프 `코드히어로` 성공리에 마쳐… 겨울방학 캠프 개시반도체·인공지능기업 네패스(대표 이병구)의 디지털교육 브랜드 '코코아팹'이 2023년 디지털새싹 2학기 캠프를 성황리에 마쳤다.디지털새싹 캠프는 교육부와 17개시·도교육청, 한국과학창의재단이 추진하는 디지털 인재양성사업으로 전국의 초, 중, 고등학생들에게 소프트웨어(SW)와 인공지능(AI) 등, 수준 높은 디지털 교육 기회를 제공하고 지역, 학교간 교육 격차 해소를 위해 마련된 국비 사업이다.지난 22년부터 디지털새싹 캠프를 지속적으로 맡아온 코코아팹은 서울, 인천권역의 초·중·고등학생을 대상으로 이번 2학기에 SW코딩, 인공지능 교육 캠프를 개설, 운영하였으며, 약 1,370여 명의 참여 학생들에게 특별한 디지털 학습 경험을 제공 하였다.올 하반기부터 AI학습 플랫폼 전문기업 팀모노리스와의 협업을 통해 중고등 대상 프로그램에 AI 학습 플랫폼 '코들'을 도입하여 디지털새싹 캠프의 한계였던 초등학교 위주 운영을 벗어나 중·고등학교의 참여 확대를 이끌어 냈다.참가한 학생들은 주어진 프로젝트와 함께 협업하고, 실생활에 디지털 기술을 연계하여 사회문제를 해결해 보는 중요한 기회를 가졌다.코코아팹과 팀모노리스의 디지털새싹 캠프는 학생들에게 창의적이고 문제 해결능력을 기를 수 있는 플랫폼을 제공하여, 미래 디지털 리더로 성장할 수 있도록 지원하고있다.- 하 략 -[기사 원문] 디지털타임스
2024-01-15
IR
GLOBAL TOP-TIER PARTNER, NEPES












![[보도]소부장 핵심기업 '네패스' 국내 복귀…공급망 퍼즐 맞춘다 -산업부 정책뉴스 이미지1](https://www.nepes.co.kr/data/bbsData/17560881619.jpg)



![[보도]네패스, 첨단 패키징 기술로 보급형 엣지 컴퓨팅 시장 공략 - 시사저널e 이미지1](https://www.nepes.co.kr/data/bbsData/17442476949.jpg)
![[보도]청주시-㈜네패스, 고성능 첨단 반도체 생산시설 증설 투자협약 체결 이미지1](https://www.nepes.co.kr/data/bbsData/17433868169.jpg)

![[보도]네패스 코코아팹, `24년도 디지털새싹`사업 성료 및 우수 프로그램 선정 이미지1](https://www.nepes.co.kr/data/bbsData/17405324919.jpg)

![[보도]네패스 디지털 교육 활성화 기여, 2년 연속 교육부 장관 표창 수상 - 디지털타임즈 이미지1](https://www.nepes.co.kr/data/bbsData/17368230239.jpg)


![[DIC2024] 김종헌 네패스 “FO 패키징 ‘생산증가 원가절감’…韓 디자인-패키징 공급망 강화해야” 이미지1](https://www.nepes.co.kr/data/bbsData/17461609899.jpg)
![[뉴스]네패스, ISMP 2024 참가 이미지1](https://www.nepes.co.kr/data/bbsData/17307866199.png)


![[보도]네패스 "2.5D 첨단 패키징으로 AI 반도체 시장 공략" 이미지1](https://www.nepes.co.kr/data/bbsData/17243815749.jpg)




![[보도]네패스 디지털 교육 활성화 기여, 교육부 장관 표창 수상 이미지1](https://www.nepes.co.kr/data/bbsData/17036449079.jpg)






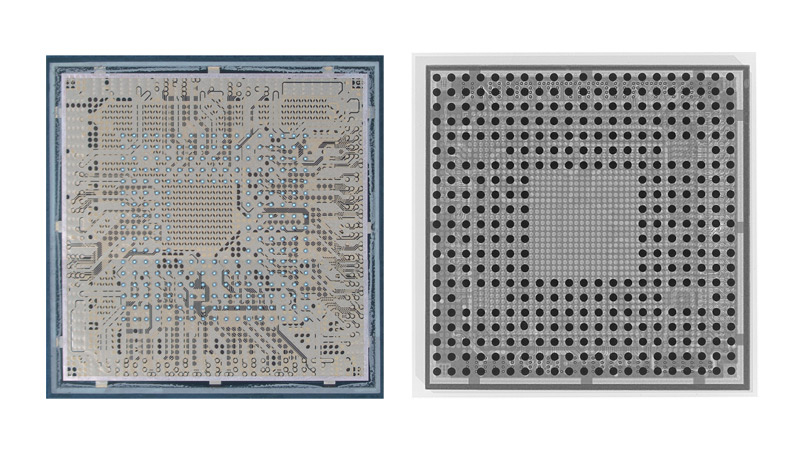

![[보도]이스라엘 AI아버지·K반도체 전격 의기투합 이미지1](https://www.nepes.co.kr/data/bbsData/16805747669.jpg)




















![[테크코리아 우리가 이끈다]네패스 - 전자신문 이미지1](https://www.nepes.co.kr/data/bbsData/16635505429.jpg)




![[반도체 패키징데이 2022]네패스, FO-PLP 적용 영역 확대 - 전자신문 이미지1](https://www.nepes.co.kr/data/bbsData/16571787239.jpeg)


![[보도자료]네패스, 미국 반도체 혁신 연합(ASIC) 가입… 글로벌 반도체 협력 강화 이미지1](https://www.nepes.co.kr/data/bbsData/16557778409.jpg)


![[보도] ㈜네패스, 폴리텍대 청주캠에 반도제 훈련 장비 기증 -충청일보 이미지1](https://www.nepes.co.kr/data/bbsData/16541327949.jpg)

![[보도]반도체 업계 “미세공정 한계, 패키징 기술 대안” 이미지1](https://www.nepes.co.kr/data/bbsData/16539562229.jpg)

![[보도]괴산군 청안면주민자치위원회, ㈜네패스아크와 자매결연 협약 이미지1](https://www.nepes.co.kr/data/bbsData/16530083659.jpg)



![[보도]반도체 지네발 없앴던 네패스 “반도체 패키징 효율 10배…3년 내 매출 1조원 달성” 이미지1](https://www.nepes.co.kr/data/bbsData/16505874909.jpg)
![[보도]이병구 네패스 회장 "반도체, 사각형으로 패키징…생산성 10배 높여" 이미지1](https://www.nepes.co.kr/data/bbsData/16505873269.jpg)

![[보도]우리 지역 글로벌 기업/2. 첨단 파운드리 인프라 확장해가는 (주)네패스 이미지1](https://www.nepes.co.kr/data/bbsData/16466976519.jpg)

![[보도]반도체 투자 활성화를 위한 기업 간담회 개최 이미지1](https://www.nepes.co.kr/data/bbsData/16450737419.jpg)


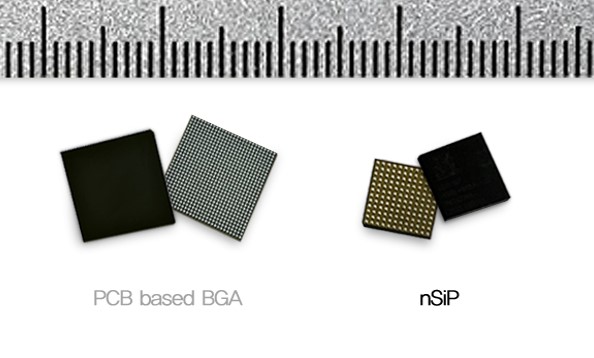


![[보도][Issue&Biz] 인공지능·빅데이터 도입…반도체공정 혁신 씨앗 심었다 이미지1](https://www.nepes.co.kr/data/bbsData/16408506559.jpg)
![[보도]충북대, 네패스의 반도체 및 IT 분야 인력 양성에 앞장 이미지1](https://www.nepes.co.kr/data/bbsData/16406768519.jpg)
![[보도]백악관도 극찬한 韓 반도체 기업…서로 존중하는 ‘슈퍼스타 경영’의 힘 이미지1](https://www.nepes.co.kr/data/bbsData/16403127989.jpg)



![[보도][제58회 무역의 날] 2억불 탑 (주)네패스 이미지1](https://www.nepes.co.kr/data/bbsData/16387707239.jpg)


![[보도][지역특화 스마트IT산업, AI융합엔진 장착] 반도체패키징·태양광 전문기업 데이터 경영 활성화 이미지1](https://www.nepes.co.kr/data/bbsData/16376595039.jpg)

![[보도][2021 독서경영 우수직장-최우수상]네패스 이미지1](https://www.nepes.co.kr/data/bbsData/16360020649.jpg)

![[보도] 반도체 패키징 첨단기술, 백악관도 찍었다 이미지1](https://www.nepes.co.kr/data/bbsData/16336551869.jpg)
![[보도]네패스, 차세대 패키징 'FO-PLP' 양산 개시…PMIC '세계 최초' 이미지1](https://www.nepes.co.kr/data/bbsData/16333950019.jpg)
![[보도] 네패스, 전통적인 웨이퍼 레벨 패키징서 한걸음 진보 이미지1](https://www.nepes.co.kr/data/bbsData/16330486029.jpg)

![[보도]반도체 초강국 이끌 '최상위 협의체' 출범 이미지1](https://www.nepes.co.kr/data/bbsData/16328146139.jpg)
![[보도]'1000억 투자' 네패스그룹, 삼성전자 협업 강화 '시그널' 이미지1](https://www.nepes.co.kr/data/bbsData/16318463439.jpg)

![[보도] [글로벌테크코리아 2021] 김종헌 네패스 CTO "차세대 패키징 기술 상용화 박차" 이미지1](https://www.nepes.co.kr/data/bbsData/16310576999.jpg)




![[보도] “네패스, 반도체 후공정인 패키징 및 테스트 기술력 보유” -뉴스투데이 이미지1](https://www.nepes.co.kr/data/bbsData/16291595169.jpg)
![[보도]첨단 반도체 패키징 기술 무장 '네패스' -전자신문 이미지1](https://www.nepes.co.kr/data/bbsData/16276038749.jpg)










![[보도] “초소형-고성능 패키징 기술로…韓 반도체 판도 바꿀 것” - 동아일보 이미지1](https://www.nepes.co.kr/data/bbsData/16196720229.jpg)
![[보도]「基板なし」が主流に 기판 공급 부족 "대란" - 日 Daily NNA 이미지1](https://www.nepes.co.kr/data/bbsData/16196608579.png)
![[보도] 폴리텍 청주캠 - 네패스 맞춤형 인력양성 업무 협의-충청타임즈 이미지1](https://www.nepes.co.kr/data/bbsData/16194047609.jpg)




![[보도]Employee-centered management drives success-The Korea Times 이미지1](https://www.nepes.co.kr/data/bbsData/16184755729.jpg)
![[보도]네패스, 반도체 총괄 회장에 정칠희 삼성전자 고문 영입 이미지1](https://www.nepes.co.kr/data/bbsData/16152477089.jpg)

![[보도]이병구 네패스 회장 "동서고금 기업 경영의 핵심은 '사람의 마음'이죠"-한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16121410139.jpg)
![[보도]네패스, '시스템인패키지(SiP)' 신기술 공개 -한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16118772609.jpg)
![[보도]High-tech parts suppliers to watch in 2021-The Korea Times 이미지1](https://www.nepes.co.kr/data/bbsData/16099940859.jpg)
![[보도]新기술에 굶주린 반도체 패키징 강자…적자 때도 2000억 투자 -한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16098368659.jpg)
![[보도]고급 패키징 수요 급증…年 평균 13% 성장 -한국경제 이미지1](https://www.nepes.co.kr/data/bbsData/16100019849.jpg)



![[보도] 뉴로모픽칩 하이엔드 CCTV 많이 채용-전파신문 이미지1](https://www.nepes.co.kr/data/bbsData/16052562179.jpg)
![[보도]'테스트 전문가' 네패스아크, 韓 시스템반도체 성장 이끈다 이미지1](https://www.nepes.co.kr/data/bbsData/16052561219.jpg)
![[보도]한동대, 네패스와 반도체 및 AI산학 협력 협약 이미지1](https://www.nepes.co.kr/data/bbsData/16052551689.jpg)
